
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
วิธีการแยกพันธะกระแสหลัก
ด้วยความก้าวหน้าของการประมวลผลเซมิคอนดักเตอร์และความต้องการชิ้นส่วนอิเล็กทรอนิกส์ที่เพิ่มขึ้น การใช้เวเฟอร์แบบบางพิเศษ (ความหนาน้อยกว่า 100 ไมโครเมตร) จึงมีความสำคัญมากขึ้น อย่างไรก็ตาม ด้วยการลดความหนาของเวเฟอร์อย่างต่อเนื่อง เวเฟอร์จึงมีความเสี่ยงสูงที่จะแตกหักในระหว่างกระบวนการต่อมา เช่น การบด การแกะสลัก และการทำให้เป็นโลหะ
โดยทั่วไปแล้วจะใช้เทคโนโลยีการเชื่อมและการแยกพันธะชั่วคราวเพื่อรับประกันประสิทธิภาพที่มั่นคงและผลผลิตของอุปกรณ์เซมิคอนดักเตอร์ แผ่นเวเฟอร์ที่บางเฉียบถูกยึดไว้ชั่วคราวบนพื้นผิวตัวพาที่แข็ง และหลังจากการประมวลผลด้านหลัง ทั้งสองจะถูกแยกออกจากกัน กระบวนการแยกนี้เรียกว่าการแยกพันธะออก ซึ่งโดยหลักแล้วประกอบด้วยการแยกพันธะด้วยความร้อน การแยกพันธะด้วยเลเซอร์ การแยกพันธะทางเคมี และการแยกพันธะเชิงกล
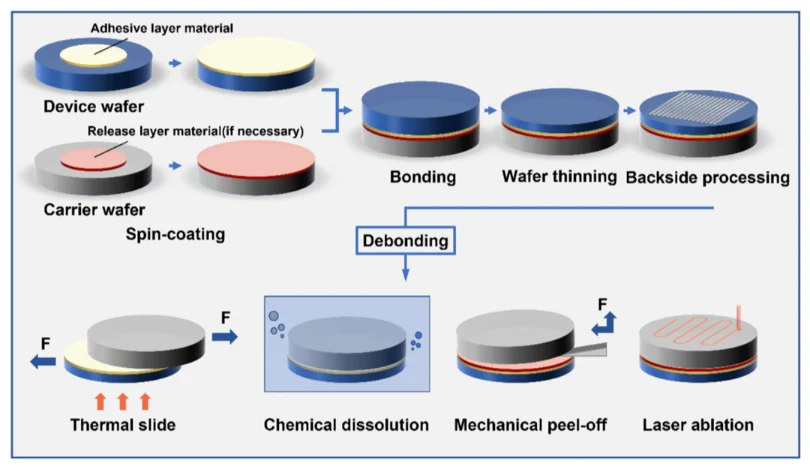
การละลายด้วยความร้อน
การดีบอนด์ด้วยความร้อนเป็นวิธีการที่แยกเวเฟอร์บางเฉียบออกจากซับสเตรตตัวพาโดยการให้ความร้อนเพื่อทำให้กาวยึดติดนิ่มและสลายตัว ส่งผลให้สูญเสียความยึดเกาะ ส่วนใหญ่จะแบ่งออกเป็น debonding สไลด์ความร้อนและ debonding การสลายตัวด้วยความร้อน
การถอดแผ่นสไลด์ด้วยความร้อนมักจะเกี่ยวข้องกับการทำความร้อนแผ่นเวเฟอร์ที่เชื่อมด้วยความร้อนจนถึงอุณหภูมิอ่อนตัวลง ซึ่งอยู่ในช่วงประมาณตั้งแต่ 190°C ถึง 220°C ที่อุณหภูมินี้ กาวยึดติดจะสูญเสียความยึดเกาะ และแผ่นเวเฟอร์บางพิเศษสามารถถูกผลักหรือลอกออกจากซับสเตรตตัวพาอย่างช้าๆ ด้วยแรงเฉือนที่ใช้โดยอุปกรณ์ต่างๆ เช่นหัวจับสูญญากาศเพื่อให้เกิดการแยกได้อย่างราบรื่น ในขณะที่อยู่ในการสลายตัวด้วยความร้อน แผ่นเวเฟอร์ที่ถูกพันธะจะถูกให้ความร้อนจนถึงอุณหภูมิที่สูงขึ้น ทำให้เกิดการสลายตัวทางเคมี (การแตกของสายโซ่โมเลกุล) ของกาว และสูญเสียการยึดเกาะโดยสิ้นเชิง ด้วยเหตุนี้ เวเฟอร์ที่ยึดติดจึงสามารถหลุดออกได้ตามธรรมชาติโดยไม่มีแรงเชิงกลใดๆ
การดีบอนดิ้งด้วยเลเซอร์
การลอกพันธะด้วยเลเซอร์เป็นวิธีการลอกพันธะที่ใช้การฉายรังสีด้วยเลเซอร์บนชั้นกาวของแผ่นเวเฟอร์ที่ถูกยึดติด ชั้นกาวจะดูดซับพลังงานเลเซอร์และสร้างความร้อน จึงเกิดปฏิกิริยาโฟโตไลติก วิธีการนี้ช่วยให้สามารถแยกเวเฟอร์แบบบางพิเศษออกจากซับสเตรตตัวพาได้ที่อุณหภูมิห้องหรืออุณหภูมิที่ค่อนข้างต่ำ
อย่างไรก็ตาม ข้อกำหนดเบื้องต้นที่สำคัญสำหรับการดีบอนดิ้งด้วยเลเซอร์ก็คือ วัสดุซับสเตรตตัวพาจะต้องโปร่งใสเท่ากับความยาวคลื่นเลเซอร์ที่ใช้ ด้วยวิธีนี้ พลังงานเลเซอร์สามารถทะลุผ่านซับสเตรตตัวพาได้สำเร็จ และถูกดูดซับอย่างมีประสิทธิภาพโดยวัสดุชั้นพันธะ ด้วยเหตุนี้ การเลือกความยาวคลื่นเลเซอร์จึงมีความสำคัญ ความยาวคลื่นโดยทั่วไปได้แก่ 248 นาโนเมตรและ 365 นาโนเมตร ซึ่งควรสอดคล้องกับลักษณะการดูดกลืนแสงของวัสดุที่ใช้ยึดติด
การแยกสารเคมี
การแยกพันธะด้วยสารเคมีทำให้สามารถแยกแผ่นเวเฟอร์ที่ยึดติดได้โดยการละลายชั้นกาวยึดติดด้วยตัวทำละลายเคมีเฉพาะ กระบวนการนี้ต้องใช้โมเลกุลของตัวทำละลายที่เจาะชั้นกาวเพื่อทำให้เกิดอาการบวม โซ่ขาด และละลายในที่สุด ซึ่งช่วยให้เวเฟอร์และซับสเตรตตัวพาที่บางเฉียบแยกตัวออกตามธรรมชาติ ดังนั้นจึงไม่จำเป็นต้องใช้อุปกรณ์ทำความร้อนเพิ่มเติมหรือแรงทางกลจากหัวจับสุญญากาศ การแยกตัวด้วยสารเคมีจะทำให้เกิดความเครียดน้อยที่สุดบนเวเฟอร์
ในวิธีนี้ เวเฟอร์ตัวพามักจะถูกเจาะล่วงหน้าเพื่อให้ตัวทำละลายสัมผัสและละลายชั้นพันธะได้เต็มที่ ความหนาของกาวส่งผลต่อประสิทธิภาพและความสม่ำเสมอของการซึมผ่านและการละลายของตัวทำละลาย กาวยึดติดที่ละลายน้ำได้ส่วนใหญ่เป็นวัสดุที่มีส่วนประกอบหลักเป็นเทอร์โมพลาสติกหรือโพลีอิไมด์ชนิดดัดแปลง ซึ่งมักใช้โดยการเคลือบแบบหมุน
การแยกตัวทางกล
การแยกส่วนด้วยกลไกจะแยกแผ่นเวเฟอร์บางพิเศษออกจากซับสเตรตตัวพาชั่วคราว โดยใช้แรงลอกเชิงกลที่ควบคุมได้ โดยไม่ต้องใช้ความร้อน ตัวทำละลายเคมี หรือเลเซอร์ กระบวนการนี้คล้ายกับการลอกเทปออก โดยที่แผ่นเวเฟอร์จะถูก "ยก" อย่างนุ่มนวลผ่านการทำงานทางกลที่มีความแม่นยำ
Semicorex นำเสนอคุณภาพสูงหัวจับเซรามิก Debonding SIC ที่มีรูพรุน. หากคุณมีข้อสงสัยหรือต้องการรายละเอียดเพิ่มเติม โปรดอย่าลังเลที่จะติดต่อเรา
โทรศัพท์ติดต่อ # +86-13567891907
อีเมล์: sales@semicorex.com




