
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe ในการผลิตชิป: รายงานข่าวระดับมืออาชีพ
วิวัฒนาการของวัสดุเซมิคอนดักเตอร์
ในขอบเขตของเทคโนโลยีเซมิคอนดักเตอร์สมัยใหม่ การขับเคลื่อนอย่างไม่หยุดยั้งไปสู่การย่อขนาดได้ผลักดันขีดจำกัดของวัสดุที่ใช้ซิลิกอนแบบดั้งเดิม เพื่อตอบสนองความต้องการประสิทธิภาพสูงและการใช้พลังงานต่ำ SiGe (ซิลิคอนเจอร์เมเนียม) จึงกลายเป็นวัสดุคอมโพสิตที่ได้รับเลือกในการผลิตชิปเซมิคอนดักเตอร์ เนื่องจากมีคุณสมบัติทางกายภาพและทางไฟฟ้าที่เป็นเอกลักษณ์ บทความนี้จะเจาะลึกถึงกระบวนการเยื่อบุผิวของ SiGe และบทบาทของมันในการเจริญเติบโตของเยื่อบุผิว การใช้งานซิลิคอนที่ตึงเครียด และโครงสร้าง Gate-All-Around (GAA)
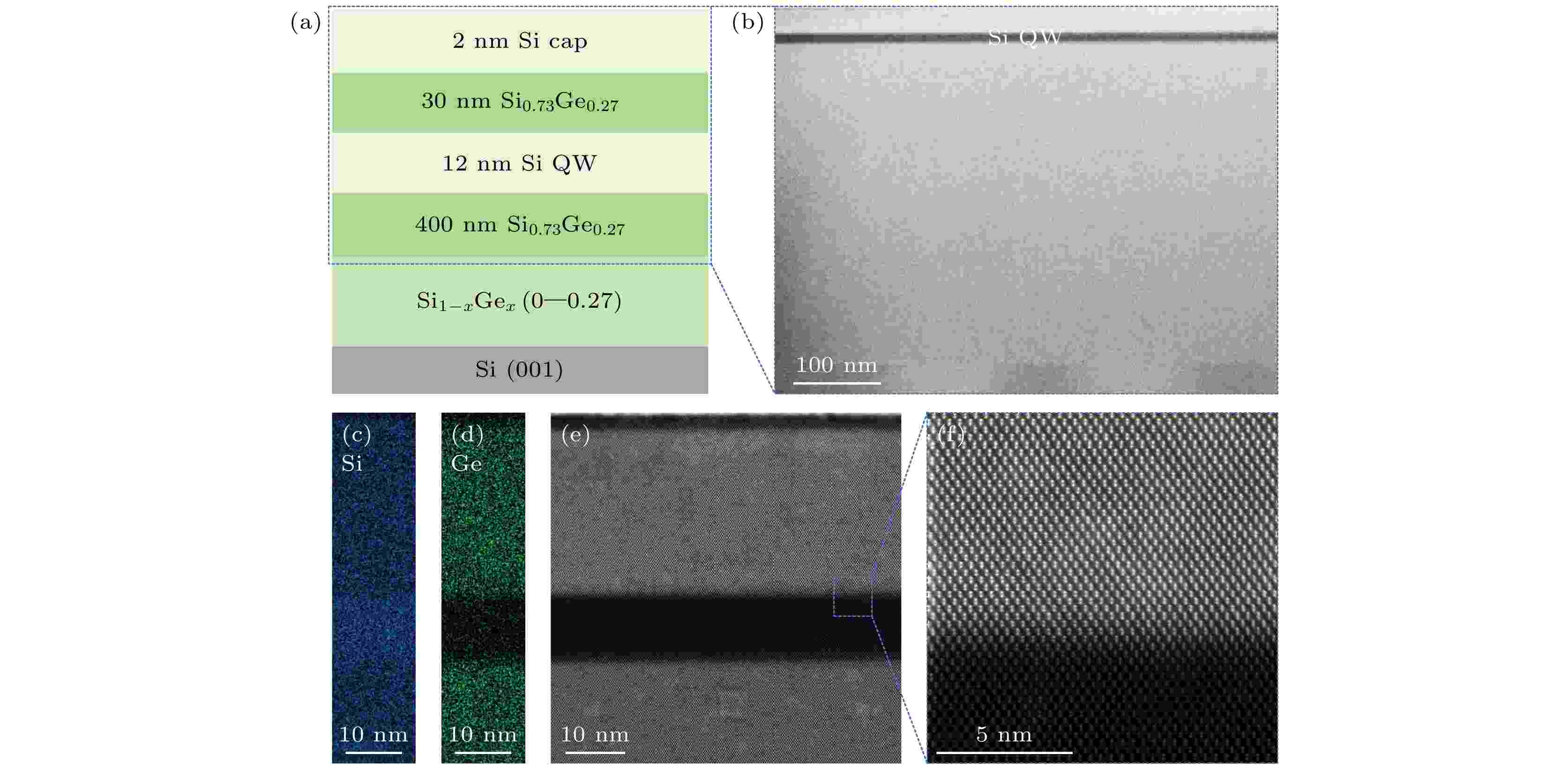
ความสำคัญของ SiGe Epitaxy
1.1 ข้อมูลเบื้องต้นเกี่ยวกับ Epitaxy ในการผลิตชิป:
Epitaxy มักเรียกโดยย่อว่า Epi หมายถึงการเติบโตของชั้นผลึกเดี่ยวบนซับสเตรตของผลึกเดี่ยวที่มีการจัดเรียงแบบขัดแตะเดียวกัน เลเยอร์นี้สามารถเป็นได้ทั้งโฮโมอีพิเทเชียล (เช่น Si/Si)หรือเฮเทอโรอีพิแอกเซียล (เช่น SiGe/Si หรือ SiC/Si) มีการใช้วิธีการต่างๆ เพื่อการเจริญเติบโตของเยื่อบุผิว รวมถึง Molecular Beam Epitaxy (MBE), การสะสมไอสารเคมีสุญญากาศสูงพิเศษ (UHV/CVD), Epitaxy ในบรรยากาศและความดันลดลง (ATM และ RP Epi) บทความนี้มุ่งเน้นไปที่กระบวนการ epitaxy ของซิลิคอน (Si) และซิลิคอนเจอร์เมเนียม (SiGe) ที่ใช้กันอย่างแพร่หลายในการผลิตวงจรรวมเซมิคอนดักเตอร์โดยใช้ซิลิคอนเป็นวัสดุตั้งต้น
1.2 ข้อดีของ SiGe Epitaxy:
ผสมผสานเจอร์เมเนียม (Ge) ในสัดส่วนหนึ่งระหว่างกระบวนการเยื่อบุผิวสร้างชั้นคริสตัลเดี่ยวของ SiGe ซึ่งไม่เพียงแต่ลดความกว้างของแบนด์แก็ป แต่ยังเพิ่มความถี่คัตออฟของทรานซิสเตอร์ (fT) อีกด้วย ทำให้สามารถใช้งานได้อย่างกว้างขวางในอุปกรณ์ความถี่สูงสำหรับการสื่อสารไร้สายและออปติคัล นอกจากนี้ ในกระบวนการวงจรรวม CMOS ขั้นสูง ตาข่ายที่ไม่ตรงกัน (ประมาณ 4%) ระหว่าง Ge และ Si ทำให้เกิดความเครียดของตาข่าย เพิ่มความคล่องตัวของอิเล็กตรอนหรือรู และทำให้กระแสอิ่มตัวของอุปกรณ์และความเร็วการตอบสนองเพิ่มขึ้น
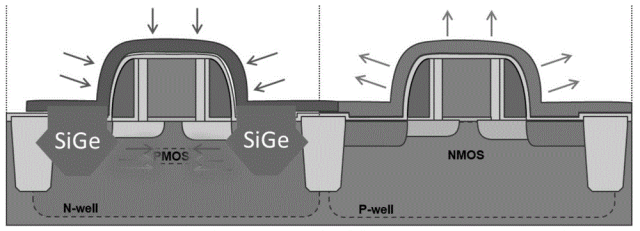
โฟลว์กระบวนการ SiGe Epitaxy ที่ครอบคลุม
2.1 การบำบัดเบื้องต้น:
เวเฟอร์ซิลิคอนได้รับการบำบัดล่วงหน้าตามผลลัพธ์ของกระบวนการที่ต้องการ โดยหลักแล้วจะเกี่ยวข้องกับการกำจัดชั้นออกไซด์ตามธรรมชาติและสิ่งสกปรกบนพื้นผิวเวเฟอร์ สำหรับเวเฟอร์ซับสเตรตที่มีการเจือปนสูง จำเป็นอย่างยิ่งที่จะต้องพิจารณาว่าจำเป็นต้องทำการซีลกลับเพื่อลดการเติมสารเจืออัตโนมัติในภายหลังหรือไม่การเจริญเติบโตของเยื่อบุผิว.
2.2 ก๊าซการเจริญเติบโตและสภาวะ:
ก๊าซซิลิคอน: ไซเลน (SiH₄), ไดคลอโรซิเลน (DCS, SiH₂Cl₂) และไตรคลอโรซิเลน (TCS, SiHCl₃) เป็นแหล่งก๊าซซิลิคอนที่ใช้กันมากที่สุดสามแหล่ง SiH₄ เหมาะสำหรับกระบวนการเอพิแทกซีแบบเต็มที่อุณหภูมิต่ำ ในขณะที่ TCS ซึ่งเป็นที่รู้จักในเรื่องอัตราการเติบโตที่รวดเร็ว นั้นถูกนำมาใช้กันอย่างแพร่หลายในการเตรียมสารที่มีความหนาซิลิกอน epitaxyชั้น
ก๊าซเจอร์เมเนียม: Germane (GeH₄) เป็นแหล่งหลักในการเติมเจอร์เมเนียม ซึ่งใช้ร่วมกับแหล่งซิลิคอนเพื่อสร้างโลหะผสม SiGe
Selective epitaxy: การเจริญเติบโตแบบเลือกทำได้โดยการปรับอัตราสัมพัทธ์ของการสะสมของเยื่อบุผิวและการแกะสลักในแหล่งกำเนิดโดยใช้ DCS ก๊าซซิลิกอนที่มีคลอรีน การเลือกสรรเกิดจากการดูดซับของอะตอม Cl บนพื้นผิวซิลิคอนน้อยกว่าการดูดซับบนออกไซด์หรือไนไตรด์ ซึ่งเอื้อต่อการเจริญเติบโตของเยื่อบุผิว SiH₄ ซึ่งไม่มีอะตอม Cl และมีพลังงานกระตุ้นต่ำ โดยทั่วไปจะใช้เฉพาะกับกระบวนการเอพิแทกซีแบบเต็มที่อุณหภูมิต่ำเท่านั้น แหล่งซิลิคอนที่ใช้กันทั่วไปอีกแหล่งหนึ่งคือ TCS มีความดันไอต่ำและเป็นของเหลวที่อุณหภูมิห้อง ซึ่งทำให้ H₂ เกิดฟองเพื่อแนะนำเข้าไปในห้องปฏิกิริยา อย่างไรก็ตาม มีราคาไม่แพงนักและมักใช้สำหรับอัตราการเติบโตที่รวดเร็ว (สูงถึง 5 μm/นาที) เพื่อเพิ่มชั้นซิลิคอน epitaxy ที่หนาขึ้น ซึ่งใช้กันอย่างแพร่หลายในการผลิตเวเฟอร์ epitaxy ของซิลิคอน
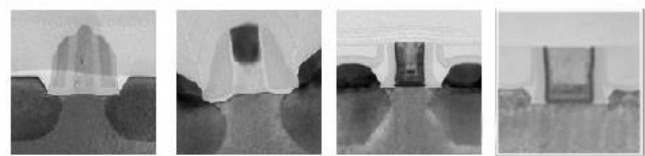
ซิลิคอนที่เครียดในชั้นอีพิแอกเชียล
ในระหว่างการเจริญเติบโตของเยื่อบุผิวSi ผลึกเดี่ยวแบบ epitaxis ถูกสะสมอยู่บนชั้น SiGe ที่ผ่อนคลาย เนื่องจากโครงตาข่ายไม่ตรงกันระหว่าง Si และ SiGe ชั้นผลึกเดี่ยวของ Si จึงต้องรับความเครียดแรงดึงจากชั้น SiGe ที่อยู่ด้านล่าง ซึ่งช่วยเพิ่มการเคลื่อนที่ของอิเล็กตรอนในทรานซิสเตอร์ NMOS อย่างมีนัยสำคัญ เทคโนโลยีนี้ไม่เพียงแต่เพิ่มกระแสอิ่มตัว (Idsat) แต่ยังปรับปรุงความเร็วการตอบสนองของอุปกรณ์อีกด้วย สำหรับอุปกรณ์ PMOS ชั้น SiGe จะถูกขยายแบบ epitaxisly ในบริเวณแหล่งกำเนิดและท่อระบายน้ำหลังจากการแกะสลักเพื่อแนะนำแรงกดอัดบนช่อง เพิ่มการเคลื่อนที่ของรู และเพิ่มกระแสอิ่มตัว
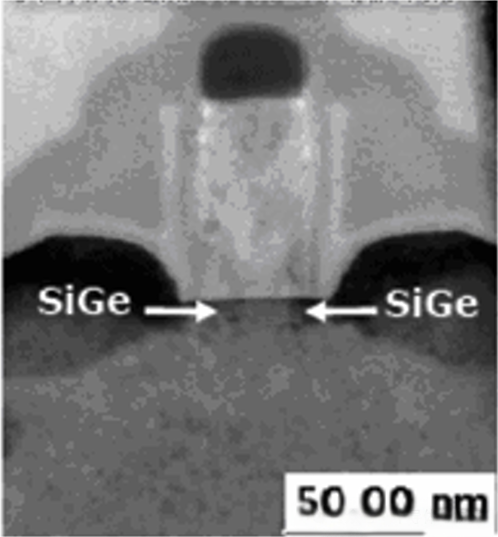
SiGe เป็นเลเยอร์สังเวยในโครงสร้าง GAA
ในการผลิตทรานซิสเตอร์สายนาโน Gate-All-Around (GAA) ชั้น SiGe ทำหน้าที่เป็นชั้นสังเวย เทคนิคการกัดแบบแอนไอโซทรอปิกที่มีการคัดเลือกสูง เช่น การกัดแบบชั้นเสมือนอะตอม (quasi-ALE) ช่วยให้สามารถกำจัดชั้น SiGe ได้อย่างแม่นยำเพื่อสร้างโครงสร้างเส้นลวดนาโนหรือแผ่นนาโน
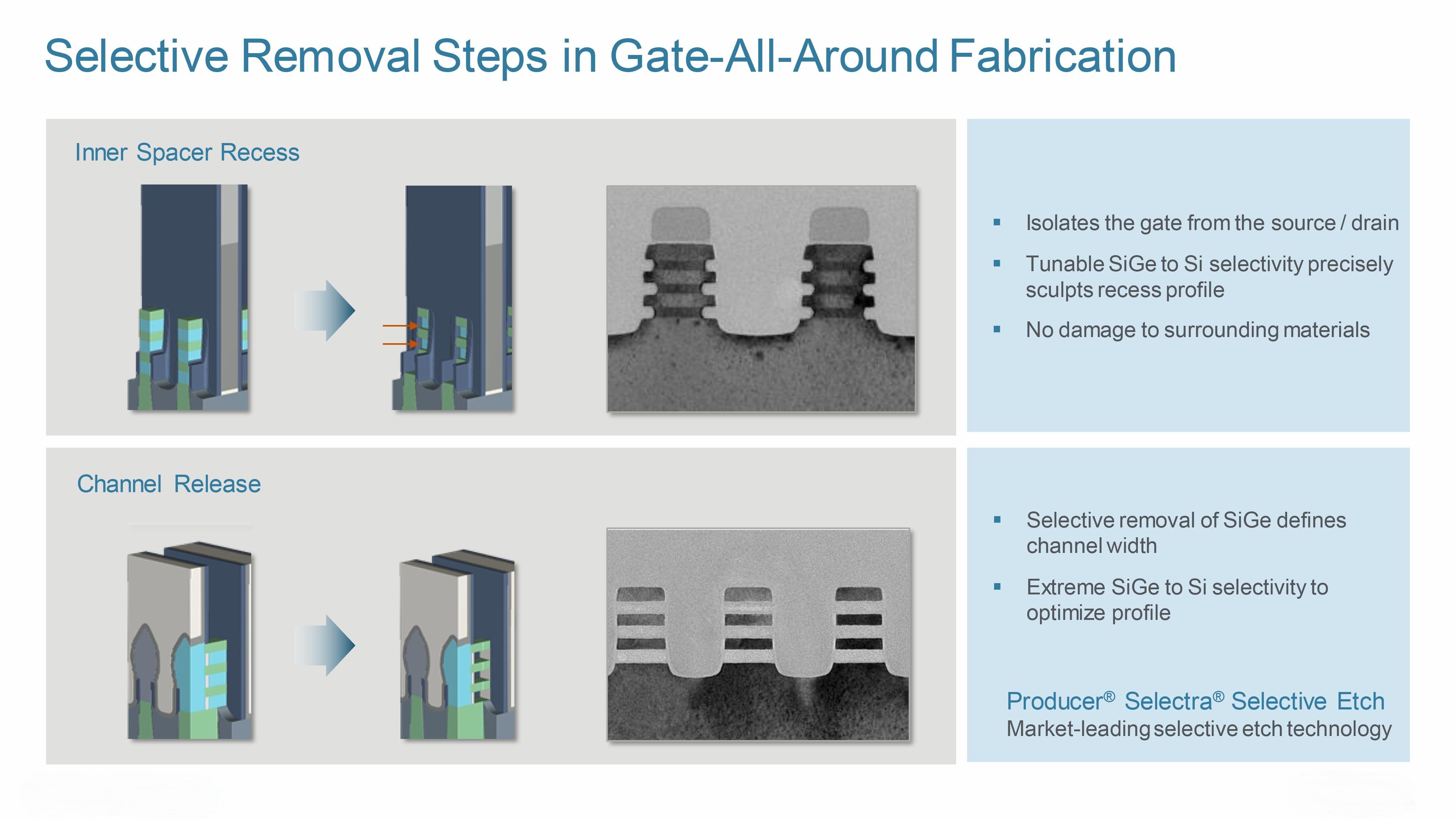
พวกเราที่ Semicorex เชี่ยวชาญด้านโซลูชันกราไฟท์เคลือบ SiC/TaCนำไปใช้ในการเจริญเติบโตของ Si epitaxis ในการผลิตเซมิคอนดักเตอร์ หากคุณมีข้อสงสัยหรือต้องการรายละเอียดเพิ่มเติม โปรดอย่าลังเลที่จะติดต่อเรา
โทรศัพท์ติดต่อ: +86-13567891907
อีเมล์: sales@semicorex.com




