
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
เทคโนโลยีการแกะสลักแบบคัดเลือก SiGe และ Si
Gate-All-Around FET (GAAFET) ซึ่งเป็นสถาปัตยกรรมทรานซิสเตอร์เจเนอเรชันถัดไปที่พร้อมจะเข้ามาแทนที่ FinFET ได้รับความสนใจอย่างมากจากความสามารถในการควบคุมไฟฟ้าสถิตที่เหนือกว่าและเพิ่มประสิทธิภาพในขนาดที่เล็กลง ขั้นตอนที่สำคัญในการสร้าง GAAFET ชนิด n เกี่ยวข้องกับการเลือกสรรสูงการแกะสลักของ SiGe:Si จะเรียงตัวกันก่อนการสะสมของตัวเว้นระยะภายใน ทำให้เกิดแผ่นนาโนซิลิคอนและช่องปล่อย

บทความนี้เจาะลึกการคัดเลือกเทคโนโลยีการแกะสลักมีส่วนร่วมในกระบวนการนี้และแนะนำวิธีการแกะสลักแบบใหม่สองวิธี ได้แก่ การกัดแบบไร้พลาสมาด้วยก๊าซออกซิเดชันสูง และการกัดแบบอะตอมมิกเลเยอร์ (ALE) ซึ่งนำเสนอโซลูชั่นใหม่เพื่อให้ได้ความแม่นยำสูงและการเลือกสรรในการกัด SiGe
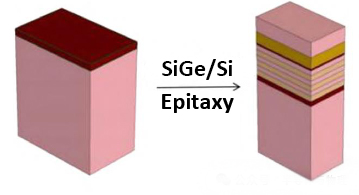
เลเยอร์ SiGe Superlattice ในโครงสร้าง GAA
ในการออกแบบ GAAFET จะมีการสลับเลเยอร์ของ Si และ SiGe เพื่อเพิ่มประสิทธิภาพของอุปกรณ์ปลูกแบบ epitaxly บนพื้นผิวซิลิกอนทำให้เกิดโครงสร้างหลายชั้นที่เรียกว่าซูเปอร์แลตทิซ ชั้น SiGe เหล่านี้ไม่เพียงแต่ปรับความเข้มข้นของตัวพา แต่ยังปรับปรุงการเคลื่อนที่ของอิเล็กตรอนด้วยการแนะนำความเครียด อย่างไรก็ตาม ในขั้นตอนกระบวนการต่อๆ ไป ชั้น SiGe เหล่านี้จำเป็นต้องถูกเอาออกอย่างแม่นยำ ในขณะที่ยังคงชั้นซิลิคอนไว้ ซึ่งต้องใช้เทคโนโลยีการกัดแบบคัดเลือกสูง
วิธีการแกะสลักแบบเลือกสรรของ SiGe
การกัดแบบไร้พลาสมาด้วยแก๊สออกซิเดชันสูง
การเลือกก๊าซ ClF3: วิธีการกัดกรดนี้ใช้ก๊าซออกซิเดชั่นสูงโดยมีค่าหัวกะทิสูง เช่น ClF3 เพื่อให้ได้อัตราส่วนหัวกะทิของ SiGe:Si ที่ 1000-5000 สามารถทำได้ที่อุณหภูมิห้องโดยไม่ทำให้พลาสมาเสียหาย
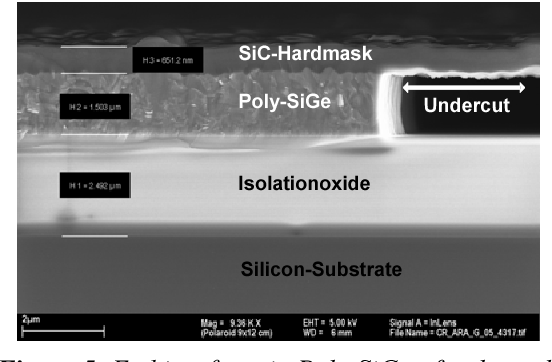
ประสิทธิภาพที่อุณหภูมิต่ำ: อุณหภูมิที่เหมาะสมที่สุดคือประมาณ 30°C ทำให้มีการเลือกสรรสูงภายใต้สภาวะอุณหภูมิต่ำ หลีกเลี่ยงการเพิ่มงบประมาณด้านความร้อนเพิ่มเติม ซึ่งเป็นสิ่งสำคัญสำหรับการรักษาประสิทธิภาพของอุปกรณ์
สภาพแวดล้อมที่แห้ง: โดยรวมกระบวนการแกะสลักดำเนินการภายใต้สภาวะที่แห้งสนิท ช่วยลดความเสี่ยงของการยึดเกาะของโครงสร้าง
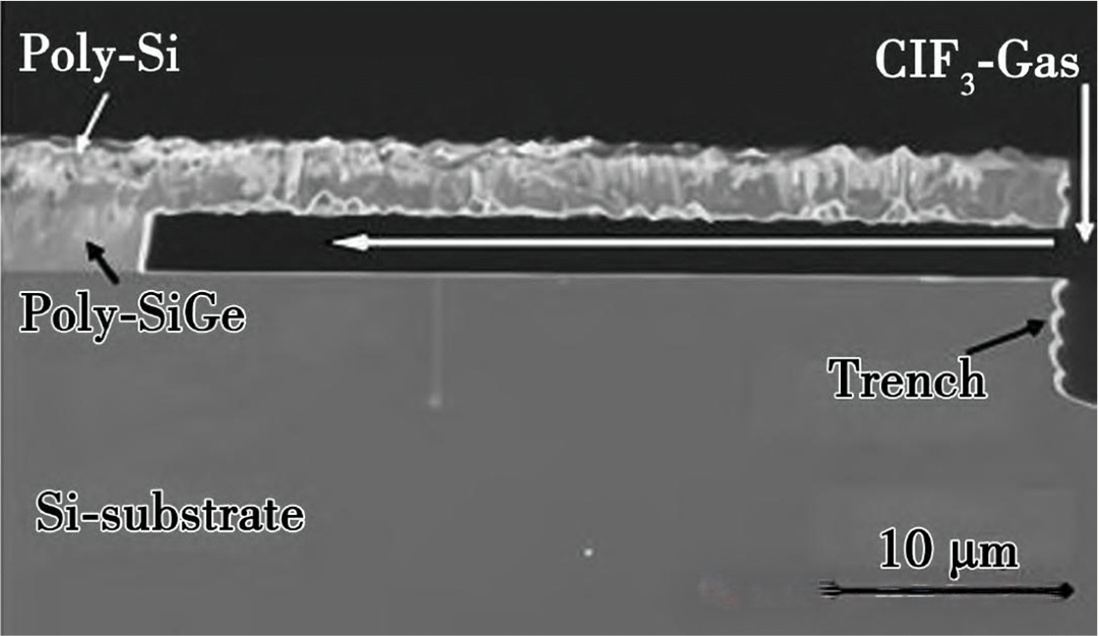
การแกะสลักชั้นอะตอม (ALE)
ลักษณะการจำกัดตัวเอง: ALE เป็นวงจรสองขั้นตอนเทคโนโลยีการแกะสลักโดยที่พื้นผิวของวัสดุที่จะแกะสลักได้รับการแก้ไขในขั้นแรก จากนั้นชั้นที่แก้ไขจะถูกลบออกโดยไม่กระทบต่อชิ้นส่วนที่ไม่มีการดัดแปลง แต่ละขั้นตอนมีการจำกัดตัวเอง จึงรับประกันความแม่นยำถึงระดับการกำจัดชั้นอะตอมเพียงไม่กี่ชั้นในแต่ละครั้ง
การแกะสลักแบบวน: สองขั้นตอนข้างต้นจะถูกวนซ้ำ ๆ จนกว่าจะได้ความลึกของการแกะสลักตามที่ต้องการ กระบวนการนี้ช่วยให้ ALE บรรลุเป้าหมายได้การแกะสลักที่มีความแม่นยำระดับอะตอมในช่องเล็กๆ บนผนังด้านใน

พวกเราที่ Semicorex เชี่ยวชาญด้านโซลูชันกราไฟท์เคลือบ SiC/TaCใช้ในกระบวนการแกะสลักในการผลิตเซมิคอนดักเตอร์ หากคุณมีข้อสงสัยหรือต้องการรายละเอียดเพิ่มเติม โปรดอย่าลังเลที่จะติดต่อเรา
โทรศัพท์ติดต่อ: +86-13567891907
อีเมล์: sales@semicorex.com




